首页
关于睿晖
产品系列
Underfill底部填充胶操作步骤
浏览: 发布日期:2019/03/21Underfill底部填充胶操作步骤(使用说明):
1、底部填充胶的储存温度介于2℃~8℃之间(KY6200例外,-25~-15℃),使用将之在室温下放置1小时以上,使产品恢复至室温才可以使用。
2、underfill底填胶操作前,应确保产品中无气泡。
3、注胶时,需要将Underfill电路板进行预热,可以提高产品的流动性,建议预热温度:40~60℃。
4、开始给BGA镜片做L型路径的第一次点胶,如下图将KY底部填充胶点在BGA晶片的边缘。
5、等待约30~60秒时间,待KY底部填充胶渗透到BGA底部。
6、给BGA晶片再做第二次L型路径点胶,注意胶量要比第一次少一点,等待大约60S左右,观察黑胶是否有扩散到BGA的四周并形成斜坡包覆晶片,此步骤的目的是确保晶片底下的underfill有最少气泡或者空洞。
备注:外溢层高度min:不可低于芯片的下底部,Max:不可超出芯片的上表面。推荐高度为芯片高度的2/3,如下图:
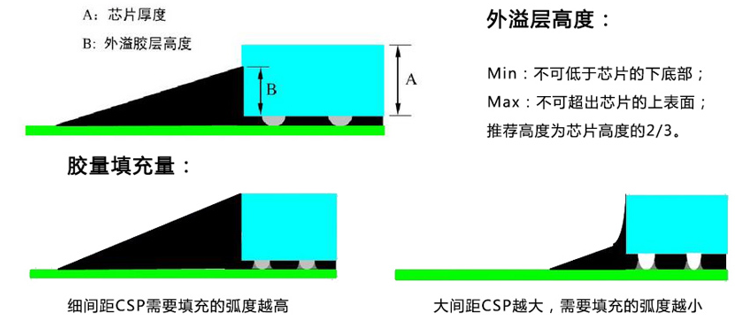
7、施胶完成后的部件按照底部填充胶产品参数中表明的固化条件进行固化。
8、烘烤后,检查灌胶的外观是否黑亮,用指甲轻触并感觉是否光滑坚硬。
9、回温后的底部填充胶应尽快用完。
上一篇:PUR热熔胶湿气固化原理
下一篇:Underfill底部填充工艺 返回列表
- 0755-23309063
- sales@hargur.com.cn
- 版权所有 ©2018-2023睿晖电子材料有限公司




